4为限位柱;5为温度传感器;6为过温保护器;7为隔热环;11为***加热区域;12为第二加热区域;13为第三加热区域;14为第四加热区域;15为第五加热区域;16为第六加热区域;17为第七加热区域。具体实施方式下面结合附图和实施例,对本发明的具体实施方式作进一步详细描述。以下实施例用于说明本发明,但不能用来限制本发明的范围。实施例一、本实施例的晶圆加热器的结构如图1至4所示包括:加热盘1、底板2和垫柱3加热盘1第二面上设有七个加热区域,分别为***加热区域11、第二加热区域12、第三加热区域13、第四加热区域14、第五加热区域15、第六加热区域16和第七加热区域17;***加热区域11设置于中心区域,第二加热区域12和第三加热区域13设置于***加热区域11外圆周,第四加热区域14、第五加热区域15、第六加热区域16和第七加热区域17设置于第二加热区域12和第三加热区域13外圆周;每个加热区域上均设置有若干弧形凹槽,且每个加热区域内的弧形凹槽均与相邻的弧形凹槽连接,使每个加热区域内的弧形凹槽形成串联;每个加热区域内均设置有一根加热丝,加热丝嵌于弧形凹槽内;底板2与加热盘1,使加热丝固定于加热盘1上。垫柱3为peek材料,高度为,设置在加热盘1上。外筒体4顶端与中心加热筒2顶端位于同一平面。PA10005-PCC10A加热板总经销

***温度检测模块和第二检测模块均采用型号为pt1000的铂热电阻;***加热模块包括***功率继电器和***加热丝;第二加热模块包括第二功率继电器和第二加热丝;在本实施中,晶圆加热处于温度稳定阶段,并且将控制模块的温度稳定阶段的精度值设置为℃,本领域普通技术人员可根据实际需求设置该阶段的精度值。为了更好地解释本发明,假设***温度检测模块检测到的温度值为℃,第二温度检测模块检测到的温度值为℃,控制模块接收到上述两个温度值后,通过下述公式得到差值:差值=|℃℃|=℃控制模块将上述计算得到的差值与精度值进行比较,在本实施中,差值为℃,大于精度值℃;控制模块通过增大第二功率继电器的输出功率,提高第二加热丝的工作功率,直到***温度检测模块检测到的温度值和第二温度检测模块检测到的温度值之间的差值小于℃;当然本领域普通技术人员也可以通过减小***加热丝的工作功率,使得***温度检测模块检测到的温度值和第二温度检测模块检测到的温度值之间的差值小于℃。通过对热盘进行分区化的温度管理,使得热盘温度均匀,满足了高精度晶圆的加工需求。实施例2:本实施与实施例1的不同点是晶圆加热处于加热升温阶段,在该阶段控制模块的精度值设置为℃。MSA FACTORYPA8015-CC-PCC200V加热板代理碳和沙石中的二氧化硅进行化学反应。

当***分区和第二分区之间的温度值差值超过℃时,控制模块降低温度较高的分区的功率继电器的输出功率,或者控制模块提高温度降低的分区的功率继电器的输出功率。本领域普通技术人员可根据实际需求设置该阶段的精度值。通过对热盘进行分区化的温度管理,使得各个分区之间的温度差一直处在合理范围内,进而可以提高升温速率,不用担心热盘温度不均匀而损坏晶圆,**终达到了缩短晶圆加工时间,提高产量的目的。实施例3:本实施与实施例1的不同点是晶圆加热处于冷却降温阶段,在该阶段控制模块的精度值设置为℃,当***分区和第二分区之间的温度值差值超过℃时,控制模块降低温度较高的分区的功率继电器的输出功率,或者控制模块提高温度降低的分区的功率继电器的输出功率。本领域普通技术人员可根据实际需求设置该阶段的精度值。以上实施方式*用于说明本发明,而并非对本发明的限制,有关技术领域的普通技术人员,在不脱离本发明的精神和范围的情况下,还可以做出各种变化和变型,因此所有等同的技术方案也属于本发明的范畴,本发明的**保护范围应由权利要求限定。
每组加热片的形状均是拱形包抄着由中心点o向外拓展;相邻两组加热片包抄的拐点彼此错开,每组加热片的自由端分别连结电源的两极。其中,加热片的数目可以是如图4所示为两组,包括:***加热片6和第二加热片7;所述***加热片6的***迂回端61和第二加热片7的第二迂回端71彼此纵横组成曲折的留置区8。本发明的***个实施例:如图4所示,所述每组加热片为单独设立彼此分离,座落中心点o附近的加热片的自由端连结着相同电极,***热弧片60和第二热弧片70分别与***加热片6和第二加热片7连结。在该实行例中,由于多组加热片是单独设立的,因此当加热片受热后,其自身可以具足够大的延展空间,不会影响总体的变形,从而化解了技术疑问一;而中心对称设立的多组加热片可以合理摆设加热片的电极,如图4所示,在中心对称的外边沿可以设立相同的电极,而中心点o的附近连通相同的另一个电极,这种长距离分布,可以防范电源短路,进而化解了技术疑问二。同时,为了确保加热的平稳,中心对称的加热片可以很好的通过错位,让相邻两组加热片之间的留置区8布置的更合理,而这种合理的相距可以避免图3所示的,两组加热片附近的加热片变形等,进而化解了技术疑问三。而当使用多层加热桶时,则由于加热桶体积变大、结构变得复杂,因此生产成本增加。
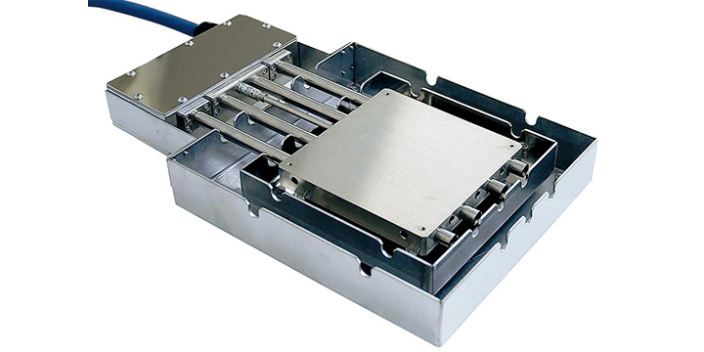
膜厚与时间的平方根成正比。因而,要形成较厚SiO2膜,需要较长的氧化时间。SiO2膜形成的速度取决于经扩散穿过SiO2膜到达硅表面的O2及OH基等氧化剂的数量的多少。湿法氧化时,因在于OH基SiO2膜中的扩散系数比O2的大。氧化反应,Si表面向深层移动,距离为SiO2膜厚的。因此,不同厚度的SiO2膜,去除后的Si表面的深度也不同。SiO2膜为透明,通过光干涉来估计膜的厚度。这种干涉色的周期约为200nm,如果预告知道是几次干涉,就能正确估计。对其他的透明薄膜,如知道其折射率,也可用公式计算出(dSiO2)/(dox)=(nox)/(nSiO2)。SiO2膜很薄时,看不到干涉色,但可利用Si的疏水性和SiO2的亲水性来判断SiO2膜是否存在。也可用干涉膜计或椭圆仪等测出。SiO2和Si界面能级密度和固定电荷密度可由MOS二极管的电容特性求得。(100)面的Si的界面能级密度**低,约为10E+10--10E+11/cm?数量级。(100)面时,氧化膜中固定电荷较多,固定电荷密度的大小成为左右阈值的主要因素。晶圆热CVD热CVD(HotCVD)/(thermalCVD),此方法生产性高,梯状敷层性佳(不管多凹凸不平,深孔中的表面亦产生反应,及气体可到达表面而附着薄膜)等,故用途极广。膜生成原理,例如由挥发性金属卤化物(MX)及金属有机化合物。该锅炉因不易发生、不易泄漏有害气体、噪音小而普遍使用。PA10005-PCC10A加热板总经销
主要涉及一种电磁感应加热单元结构。PA10005-PCC10A加热板总经销
实际关乎一种mocvd反应腔用加热板。背景技术:半导体芯片在发育时,对温场的均匀性要求较高,因此一种加热均匀且使用寿命较久的加热板对半导体芯片的制作具有至关关键的效用。通过检索,在**称谓:一种用以mocvd装置的钨涂层加热片及其制备方式(cnb)中公开了一种加热片,但是这种加热片由于中心为镂空构造并不适合半导体领域的芯片发育采用。在目前,芯片生长中用到到的加热板的构造如附图1所示,中间是形状为ω的热弧板1,在热弧板1的两侧分别连通两组拱形热片2,两组半圆形热片2是直线对称的,在半圆形热片2的自由端是分别接着电源的左电极和右电极。将这种传统的加热片放在陶瓷上通电后给上方的芯片提供平稳的热源。这种平板型加热板是一种电阻式加热方法,通过热辐射的方法,给上方的生长芯片的载体(石墨盘)加热,提供芯片生长所需的热能和温场。由于加热板的空隙22部分对应上方的载盘位置的是从未直接热辐射加热的,石墨盘此部分的受热能量是靠其他部分的热传导。另外,石墨盘是通过高速转动的(1000rpm)实现载体(石墨盘)的表面温场的均匀性(±℃)。传统的对称式构造加热片中,加热板的空隙22部分是分布在同一个同心圆圆弧上。PA10005-PCC10A加热板总经销
上海九展自动化技术有限公司在同行业领域中,一直处在一个不断锐意进取,不断制造创新的市场高度,多年以来致力于发展富有创新价值理念的产品标准,在上海市等地区的机械及行业设备中始终保持良好的商业口碑,成绩让我们喜悦,但不会让我们止步,残酷的市场磨炼了我们坚强不屈的意志,和谐温馨的工作环境,富有营养的公司土壤滋养着我们不断开拓创新,勇于进取的无限潜力,上海九展自动化供应携手大家一起走向共同辉煌的未来,回首过去,我们不会因为取得了一点点成绩而沾沾自喜,相反的是面对竞争越来越激烈的市场氛围,我们更要明确自己的不足,做好迎接新挑战的准备,要不畏困难,激流勇进,以一个更崭新的精神面貌迎接大家,共同走向辉煌回来!